- 品牌
- 普林電路,深圳普林,深圳普林電路
- 型號
- 高多層精密電路板、盲埋孔板、高頻板、混合層壓板、軟硬結合板
- 表面工藝
- 噴錫板,防氧化板,沉金板,全板電金板,插頭鍍金板
- 基材類型
- 剛撓結合線路板,剛性線路板,撓性線路板
- 基材材質
- 有機樹脂類覆銅板,金屬基覆銅板,陶瓷基覆銅板,多層板用材料,特殊基板
- 層數
- 多層,單面,雙面
- 絕緣樹脂
- 酚醛樹脂,氰酸酯樹脂(CE),環氧樹脂(EP),聚苯醚樹脂(PPO),聚酰亞胺樹脂(PI),聚酯樹脂(PET),聚四氟乙烯樹脂PTFE
- 增強材料
- 復合基,無紡布基,玻纖布基,合成纖維基
- 阻燃特性
- VO板,HB板
- 最大版面尺寸
- 520*620
- 厚度
- 0.2-6.5
- 熱沖擊性
- 288攝氏度*10秒,三次
- 成品板翹曲度
- 0.75
- 產地
- 中國
- 基材
- 鋁,銅
- 機械剛性
- 剛性,柔性
- 絕緣材料
- 金屬基,陶瓷基,有機樹脂
- 絕緣層厚度
- 薄型板,常規板
- 產品性質
- PCB板
PCB 的高頻高速特性使其在通信領域占據關鍵地位,成為 5G 時代的支撐元件。PCB 的高頻高速板采用羅杰斯、PTFE 等低損耗介質材料,通過控制阻抗匹配(50Ω±10%)和信號傳輸延遲(≤1ps/mm),滿足 5G 基站對毫米波頻段信號完整性的嚴苛要求。深圳普林電路生產的 8-20 層高頻板,小線寬 / 線距達 3mil/3mil,采用背鉆工藝消除 Stub 效應,配合沉金表面處理提升抗氧化性,可應用于射頻模塊、天線陣子等部件。此類 PCB 在 5G 網絡中實現每秒數十 Gb 的數據傳輸,助力構建低時延、高帶寬的通信基礎設施,成為連接萬物互聯的物理基石。PCB工業控制板強化三防處理,鹽霧測試達96小時無腐蝕。廣東按鍵PCB廠
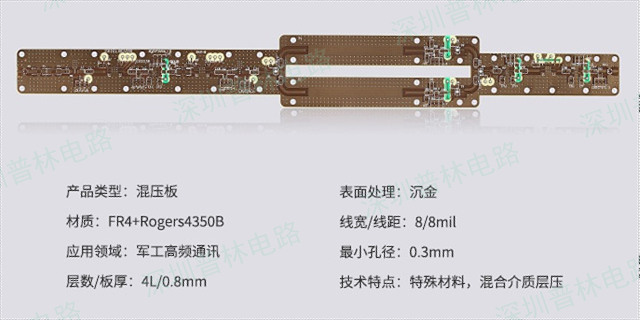
軟硬結合PCB的優勢有哪些?
抗振性與耐久性:軟硬結合PCB通過將柔性和剛性材料結合,使其在面對振動和沖擊時表現出色。柔性部分能夠有效吸收和緩解外部沖擊,從而保護電子元件免受損壞。
密封性與防水性能:在戶外設備和醫療設備中,防水性能和密封性是關鍵要求。軟硬結合PCB可以通過優化設計,在電路板的關鍵部分增加密封結構,從而提高設備的防護等級。
高密度集成電路設計:柔性部分的可折疊性和可彎曲性使得設計師可以在有限的空間內集成更多的元件和線路,從而提高設備的功能密度。這種設計特性在智能設備和便攜式電子產品中尤為關鍵。
產品外觀與設計優化:軟硬結合PCB可以根據產品的外形進行靈活調整,支持更為創新和復雜的設計需求。這種特性使得設計師能夠更自由地發揮創意,打造出更具吸引力的產品外觀。
廣泛應用領域與設計自由度:軟硬結合PCB廣泛應用于汽車電子、醫療設備和航空航天領域,支持從導航系統到醫療儀器等多種場景。其設計自由度讓工程師輕松調整電路板形狀,縮短開發周期,快速響應市場需求。
普林電路制造的軟硬結合PCB憑借其杰出的抗振性、密封性、高密度集成、設計靈活性以及廣泛的應用前景,正為各個行業的技術創新與發展提供強有力的支持。 深圳6層PCB加工廠高頻PCB通過支持高速信號傳輸,確保高性能電子設備在各種苛刻環境下仍然能保持優異的工作表現。

對于中小批量訂單,普林電路展現出了的生產能力和高效的交付速度。其生產線上配備了先進的自動化設備,這些設備能夠快速、準確地完成各項生產任務。自動化設備在提高生產效率的同時,還能降低人為因素導致的誤差。例如,在貼片工序中,高精度的貼片機能夠快速將電子元器件準確地貼裝到PCB板上,縮短了生產周期。普林電路還優化了生產調度系統,根據訂單的緊急程度和生產難度進行合理安排,確保中小批量訂單能夠在短時間內完成生產并交付給客戶,滿足客戶對快速交付的需求。
PCB 的高多層精密設計是復雜電子系統小型化的關鍵,推動人工智能與物聯網技術落地。PCB 的高多層板( 40 層)通過積層技術(BUM 工藝)和盲埋孔設計,將芯片、電容、電感等元件集成于緊湊空間內,線寬 / 線距低至 3mil/3mil,層間介質厚度 0.075mm,實現每平方英寸超 10 萬孔的高密度互聯。深圳普林電路為 AI 服務器打造的 24 層 PCB,采用混壓工藝(FR4+PTFE)結合階梯槽結構,內置電源層與信號層隔離設計,支持 PCIe 5.0 高速協議,單板可承載 20 + 顆 GPU 芯片互聯,為深度學習算力提升提供硬件保障。在物聯網領域,此類 PCB 使智能終端在方寸之間集成通信、感知、控制等多功能模塊,加速 “萬物智聯” 進程。PCB質量追溯系統記錄全流程數據,問題批次可召回。

PCB 的小批量試產服務支持客戶快速驗證設計,深圳普林電路提供 5-50㎡的中小批量快速交付。PCB 的小批量訂單通常用于新產品試產,深圳普林電路建立快速生產線,從 Gerber 文件導入到成品交付短需 5 天(6 層板)。為某電子企業生產的 50㎡帶金手指的 4 層 PCB,采用預黑化內層 + 沉金表面處理,72 小時內完成交付,客戶通過試產發現焊盤設計缺陷,及時優化后避免批量損失。此類服務降低客戶研發風險,尤其適合初創企業與高校科研團隊,年服務中小批量訂單超 10000 批次。普林電路的HDI PCB通過微細線路和混合層壓技術,滿足了小型化電子產品對高集成度和高性能的需求。廣東醫療PCB公司
嚴格的質量控制和多樣化的表面處理工藝,使我們的PCB在各類應用場景中展現出色的穩定性和耐用性。廣東按鍵PCB廠
面向醫療設備制造商,深圳普林電路建立符合ISO13485標準的質控體系,重點管控生物兼容性材料的選用(如符合USPClassVI標準的基材)及可追溯性管理。在PCB制造中采用無鉛表面處理工藝,避免ROHS禁用物質殘留;通過微切片分析確保孔壁銅厚≥25μm,滿足高頻電刀等設備的電流承載需求。PCBA階段執行潔凈室組裝,對清洗劑殘留量進行離子色譜檢測(<1.56μg/cm2),并建立滅菌驗證數據庫(環氧乙烷、伽馬射線等)。面向智能穿戴、傳感器節點等物聯網終端,普林電路開發出超小型PCB集成方案。采用HDI(高密度互連)技術實現1階激光盲孔(孔徑75μm)與3+4+3疊層結構,在20×15mm面積內集成藍牙模組、MCU及天線單元。應用半固化片流膠控制技術,將介質層厚度壓縮至25μm,線寬/線距降至40/40μm。針對紐扣電池供電場景,提供損耗設計方案(損耗角正切≤0.002@1GHz),延長設備續航時間。廣東按鍵PCB廠
- 深圳6層PCB加工廠 2025-07-15
- 深圳多層PCB廠家 2025-07-15
- 深圳手機PCB線路板 2025-07-15
- 廣東電力PCB供應商 2025-07-15
- 厚銅PCB生產廠家 2025-07-14
- 深圳6層PCB電路板 2025-07-14
- 廣東六層PCB軟板 2025-07-14
- 多層PCB廠家 2025-07-14
- 深圳特種盲槽板PCB制造 2025-07-14
- 深圳按鍵PCB技術 2025-07-14
- 深圳高TgPCB制作 2025-07-14
- 深圳PCBPCB軟板 2025-07-14


